虚拟仿真实验教学产品案例—物理类:用MOS结构C-V法测定SiO2中固定电荷及可动电荷项目
(一)内容介绍
(1)电极面积的测量及计算
通过显微镜观察测量水银探针的直径,并计算水银探针面积。

(2)实验准备
准备实验器材,选择实验用硅片,及测试前进行的氧化工艺。

(3)C-V法测定SiO2厚度
不断调节测试电压范围,测试频率,根据测定后的曲线记录相关数据,并计算SiO2氧化层厚度。
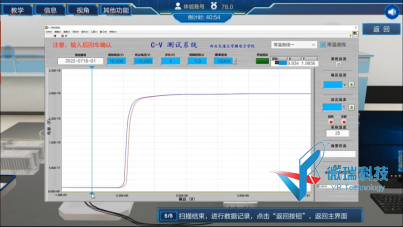

(4)C-V法测定硅片表面掺杂浓度
不断调节测试电压范围,测试频率,根据测定后的曲线记录相关数据,并计算最大耗尽层宽度和Si表面杂质浓度。


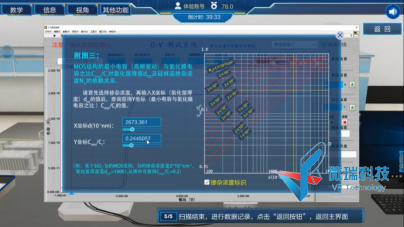
(5)计算MOS结构的平带电容
不断调节测试电压范围,测试频率,根据测定后的曲线记录相关数据,并计算平带电容。
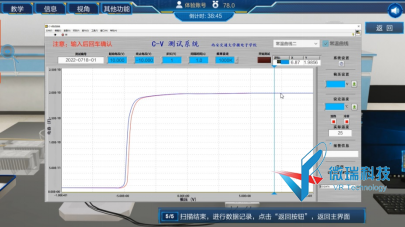

(6)C-V法测定SiO2中固定电荷及可动电荷密度
不断调节测试电压范围,测试频率,根据测定后的曲线记录相关数据,并计算SiO2中固定电荷及可动电荷密度。
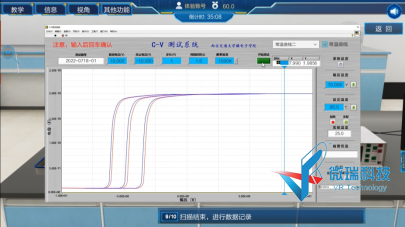

(7)界面态
不断调节测试电压范围,测试频率,观察界面态的变化规律。
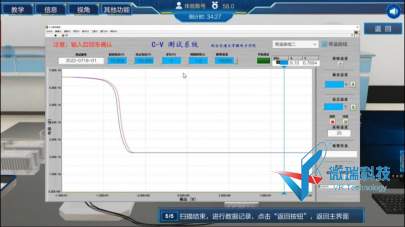
(8)实验结束
关闭实验设备,收拾实验器材,结束实验。

(二)动画
“理想”MOS是指:SiO2层的结构理想完整,无缺陷,它把Hg Si完全绝缘隔开(即电荷不能通过),SiO2中既无固定电荷,也无可动电荷,在Si—SiO2界面上也无界面态。
当Hg电极加偏压VG后,在硅片表面将感应产生电荷,形成空间电荷区,电荷数量以Qsc表示。如果改变VG的大小、正负,空间电荷区的性质(积累、平带、耗尽、反型)随着发生变化,即VG的正、负和数量发生了变化,这就是说,空间电荷区具有电容特性。


(三)实验的特色和亮点
C-V特性测试是微电子领域常用的测试手段,能够得到许多关键的工艺参数,可有效的评估工艺、材料及器件的特性。高频C-V测试是检测、研究MOS器件、半导体界面性质的重要方法,使用这种方法可以求得氧化物膜厚度、氧化层中的固定电荷密度、可动电荷密度、掺杂浓度等,还可以判断半导体材料的导电类型,因此被广泛地应用于半导体工艺、器件的研究及微电子制造业中。
(1)对实际实验规律进行仿真:对实际实验过程中的实验条件,实验参数设置进行了模拟,基于大量实际实验收集到的数据,推导出该实验中的核心影响因素变化对实验结果的影响规律,在实验后台程序中嵌入符合规律的数学模型或物理模型,在虚拟仿真实验操作过程中,系统会按照真实规律,对不同的参数设定或操作给出符合事实规律的反馈或结果。
(2)对理论微观机理的变化规律进行模拟仿真:在已经成型的科研理论研究中对微观机理进行了科学客观的描述,在每个实验模块的进行过程中将科学理论通过形象的三维形式进行了再现,同时会根据实际实验条件、参数的不同进行了相应的变化,客观体现了对象的理论模型,对微观不可见及客观存在的机理过程进行形象的阐述。
(3)对科研实验全过程进行仿真模拟:将整体科研实验的全过程,包括实验室环境、实验仪器设备、实验过程中使用到的仪器药品材料、实验过程中的现象等等,全部完整的模拟,有效地解决实际实验过程中由于实验周期长,实验过程环境要求高等问题导致的在教学过程中,无法让学生完整的进行实验操作的问题。

 售前咨询专员
售前咨询专员
